半导体 (Semiconductor)
Applied™ Sigmameltec™ SFD Mask Develop Series
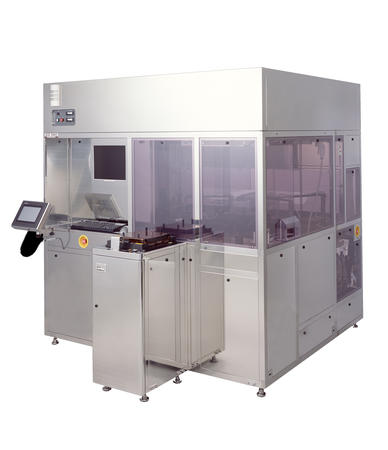
在经过严格控制的涂胶、曝光和烘焙工艺处理后,曝光后的光刻胶图案的准确显影,对于保持光掩膜原有的 CD 均匀度至关重要。这需要在掩模表面均匀同步地分配显影液;需要足够的流量来避免显影液损耗,并在所有掩模特征尺寸上实现最佳 CD 线性度;必须隔离各个化学步骤,防止液滴回弹到掩模表面上,从而避免掩模缺陷。
Sigmameltec 的 SFD 系统采用双腔室设计,将显影与最终冲洗步骤分离,腔室之间采用湿式掩模转移,以避免在显影后冲洗与最终冲洗步骤之间,掩膜变干。精确控制显影液温度和流量可确保不同掩模的 CD 平均稳定性。腔室宽阔,内壁光滑,并采用双高度区域处理,可避免微粒溅回掩模上,腔室和阶段式冲洗可维持无缺陷掩模处理所需的一致洁净度。
主要特色与优点:
- 显影和最终冲洗腔室将化学物隔离,以避免交叉污染和缺陷
- 湿腔室中的双高度区域和平滑的腔室设计可消除回溅
- 宽线性缝隙式喷头可确保均匀的显影液流,以实现最佳 CD 均匀度和一致的 CD 可重复性
- 高流速且支持反馈回路控制,可最大限度减弱负载效应和优化 CD 线性度
- 单独的冲洗喷嘴可快速抑制显影工艺,实现最佳的 CD 控制
- 湿法机械臂转移掩膜时不会破坏表面上浸置的显影液,以避免过早干燥和保护掩模特征
- 通过背面的喷嘴可同步冲洗整个掩模
- 自动化腔室和阶段式冲洗可保持洁净的环境,而无需操作员干预
