半導體 (Semiconductor)
Enlight 3光學檢測
隨著晶圓廠成本上升,在降低持有成本 (CoO) 和優化製造過程中,策略控制點之間的權衡變得更加困難,從而導致檢查的步驟數量受到更嚴格的限制。與此同時,先進電晶體的特徵尺寸極小,使致命缺陷與雜訊的區分變得非常具有挑戰性,在製造 3D 結構和執行複雜的多重圖案化步驟時,微小的差異可能會演變為致命缺陷。
Enlight™ 3 明場光學檢測系統是應材重塑製程控制的一部分,能幫助晶片製造商達到所需的檢測靈敏度和頻率,收集更多數據,加速良率提升,並降低每片晶圓成本。該系統結合了業界領先的光學技術、高解析度,與先進的 AI 演算法,使每次掃描能捕捉更多數據。其獨特的架構具有市場上最高的數值孔徑,可實現高解析度掃描,並採用獨特的3D 偏極化控制來抑制晶圓雜訊。它還具有同時進行明場和灰場檢測的通道,在生產中實現新一代高品質的大數據。
全新的訊號增強、AI 演算法和處理能力使 Enlight 3 成為我們最強的光學檢測系統。Enlight 3的應用範圍非常廣泛,從高端明場檢測到每小時 30 片晶圓的(WPH)暗場應用。
晶片製造商可能會降低檢測工具的靈敏度以減少誤報,但這會增加漏掉關鍵缺陷的風險。為了緩解這一挑戰,應材 ExtractAI* 利用 Enlight 3 的大數據,幫助客戶在在線監控的過程中,快速建立完整分類的無雜訊地圖。
Enlight 3 系統的預測功能結合應材第三代 ExtractAI 技術,為明場光學晶圓檢測和我們業界領先的電子束審查系統 SemVision™ 提供實時智慧連線。這個強大的三重組合能夠產生自適應的的AI模式識別,製程工程師可以利用這些模式識別,提出有關致命缺陷的可操作見解,或是由晶片製造商用於降低擁有成本、提升良率、加速開發、縮短上市時間,並在節點的生命週期內增加利潤。

應材的 Enlight 光學檢測、ExtractAI™ 技術和 SemVision 電子束審查系統共同提供最具可操作性的數據,以最快速度加速新製程節點的上市時間。


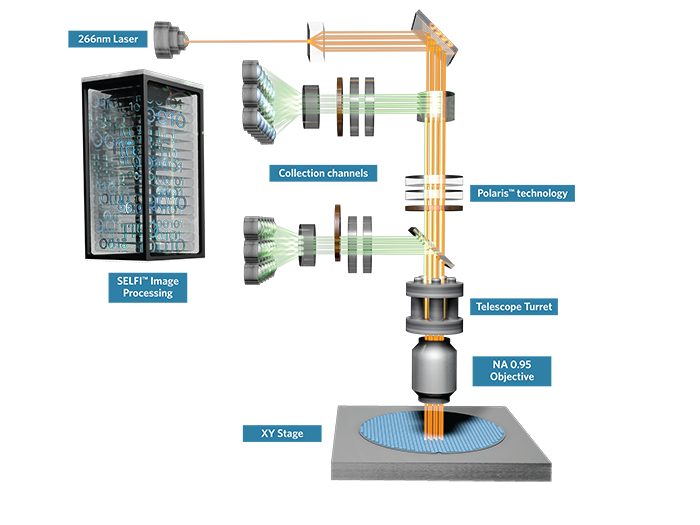
- 1 / 3
- 2 / 3
- 3 / 3
*ExtractAI 技術能夠快速、準確地從高端光學掃描儀生成的數百萬個干擾信號或「雜訊」中區分出致命缺陷。ExtractAI 技術效率極高;僅檢查 0.001X 樣本,就能對晶圓地圖上的所有潛在缺陷進行表徵。 成果是一張可操作的分類缺陷地圖,加速了節點開發、提升產能和良率。
