Back to Menu
Enlight光学ウェーハ検査
製造コストの高騰により、所有コスト(CoO)の最小化と製造工程における戦略的管理ポイントの最適化との間の古典的なトレードオフがより困難になり、検査工程数の制限が厳しくなっています。同時に、最先端トランジスタのフィーチャサイズは極めて小さいため、歩留まりを低下させる欠陥をノイズと区別することは非常に困難であり、3D構造の製造や複雑なマルチパターニング工程では、わずかなばらつきが歩留まりを低下させる欠陥に発展する可能性があります。
明視野光学検査装置Enlight™ 3は、アプライド マテリアルズのプロセス管理改革アプローチの一環であり、チップメーカーが要求される検査感度と検査頻度を達成し、より多くのデータを収集し、歩留まりを向上させ、ウェーハ1枚当たりのコストを削減することを可能にします。このシステムは、業界をリードする光学技術と高解像度、そしてスキャンごとにより多くのデータをキャプチャする高度なAIアルゴリズムを組み合わせています。その独自のアーキテクチャは、市場で最大の開口数を特徴とし、高解像度のスキャンを実現し、ウェーハノイズを抑制する独自の3D偏光制御を備えています。また、明視野とグレーフィールドの同時検出チャンネルを搭載し、新世代の高品質ビッグデータを生産現場で実現します。
新たな信号強化、AIアルゴリズム、スループット能力により、Enlight 3は当社最高性能の光学検査オプションとなりました。また、Enlight 3は、ハイエンドの明視野から毎時30枚(WPH)の暗視野アプリケーションまで、非常に広いアプリケーション領域をカバーしています。
チップメーカーは擬似検出を最小限にするために検査ツールの感度を下げることがありますが、これは重大な欠陥を見逃すリスクを高めます。この課題を解決するために、Applied ExtractAI*はEnlight 3からのビッグデータを使用して、インライン・モニタリング中に完全に分類されたノイズフリーマップを迅速に作成できるようにします。
Enlight 3とアプライド マテリアルズの第3世代ExtractAIテクノロジーは、明視野光学ウエハ検査と業界をリードする電子ビーム・レビューシステムSEMVision™をリアルタイムでインテリジェントにリンクします。この強力なトリオにより、プロセスエンジニアは適応性のあるAIベースのパターン認識を実現し、歩留まりを低下させる欠陥に関する実用的な洞察を得ることができます。

アプライド マテリアルズのEnlight光学的検査、ExtractAI™テクノロジー、SEMVision電子ビームレビューが一体となって、最も実用的なデータを最速で提供し、新プロセスノードの市場投入までの時間を短縮します。


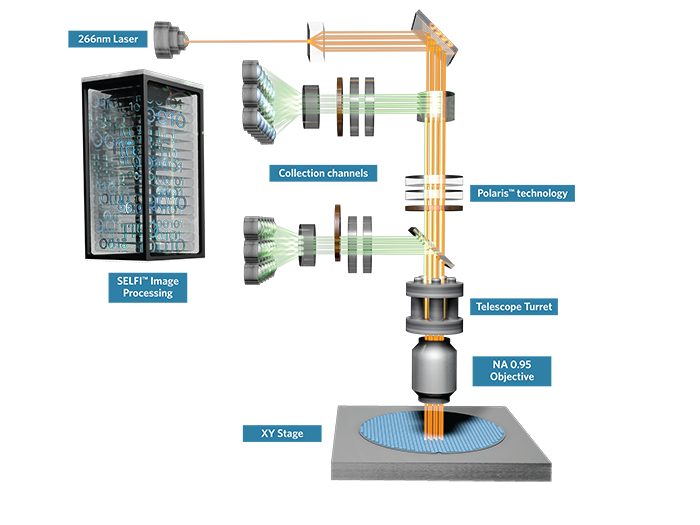
- 1 / 3
- 2 / 3
- 3 / 3
*ExtractAIテクノロジーは、ハイエンドの光学スキャナーから発生する何百万もの擬似信号や「ノイズ」から、歩留まりを低下させる欠陥を迅速かつ正確に区別します。 ExtractAIテクノロジーは非常に効率的で、わずか0.001倍のサンプルをレビューするだけで、ウェーハマップ上の潜在的な欠陥をすべて特性化します。その結果、分類された欠陥の実用的なマップが得られ、ノードの開発、立ち上げ、歩留まりを加速します。その結果、分類された欠陥の実用的なマップが得られ、ノードの開発、立ち上げ、歩留まりを加速します。
