半导体 (Semiconductor)
解决方案与软件
Enlight 3 光学检测
不断增长的晶圆厂成本使最小化拥有成本 (CoO) 和优化制造序列中战略控制点之间的传统权衡方法变得更加困难,从而导致对检查步骤数量的更严格限制。 同时,尖端晶体管的结构 尺寸非常小,这导致影响良率的缺陷很难与噪声区分开来,在制造 3D 结构和执行复杂的多重图案化步骤时,微小的差异都可能演变为影响良率的缺陷。
Enlight ™ 3 明场光学检测系统是应用材料公司优化过程控制方法的一部分,使得芯片制造商能够实现所需的检测灵敏度和频率、收集更多数据、提升良率并降低单晶圆成本。 该系统结合了行业领先的光学技术、高分辨率和先进的人工智能算法,每次扫描可捕获更多数据。 其独特的架构具有市场上极高的数值孔径,可实现高分辨率扫描,并具有独特的3D偏振控制,可抑制晶圆噪声。 它还具有同时明场和灰场检测通道,支持生产新一代高质量大数据芯片。
新的信号增强技术、人工智能算法和吞吐能力使Enlight 3 成为我们强大的光学检测选项。 Enlight 3 还涵盖了非常大的应用空间,从高端明场到每小时 30 个晶圆 (WPH) 的暗场应用。
芯片制造商可能会降低检查工具的灵敏度以尽量减少干扰检测,但这会增加错过关键缺陷的风险。 为了缓解这一挑战,应用材料公司的 ExtractAI* 利用Enlight 3的大数据帮助客户在在线监测过程中快速创建完全分类的无噪声地图。
Enlight 系统的预测能力 与应用材料公司的第三代ExtractAI技术相结合,在明场光学晶圆检测与我们业界领先的电子束检测系统SEMVision™之间建立了实时智能链接。 这项强大的三重技术可产生基于人工智能的自适应图像识别,工艺工程师可以利用这些图像识别并获得有关影响良率缺陷的可行见解,或者可被芯片制造商用来降低运营成本、提升良率、加速开发、加快收入实现时间并在节点的整个生命周期内增加利润。

应用材料公司的 Enlight 光学检测、ExtractAI ™技术和 SEMVision 电子束检测共同以极快的速度提供可操作的数据,以加快新工艺节点的上市时间。


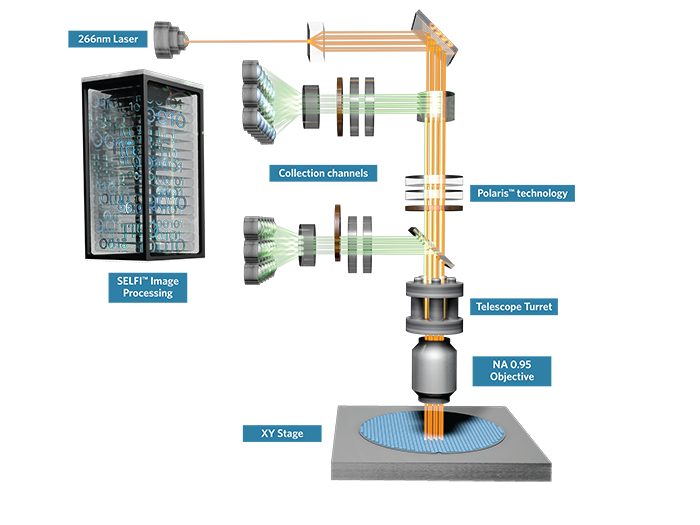
- 1 / 3
- 2 / 3
- 3 / 3
*ExtractAI 技术可以快速准确地区分影响良率的缺陷与高端光学扫描仪产生的数百万个干扰信号或“噪音”。 ExtractAI 技术非常高效;它仅需检查 0.001X 的样本即可在晶圆图上描述出所有潜在缺陷。 其结果是形成了一份可操作的分类缺陷图,可加速节点的开发、爬坡和良率。
