Back to Menu
Enlight 3 광학 검사
팹 비용의 증가는 보유 비용(CoO)을 최소화하는 것과 제조 과정에 따른 전략적 제어 지점을 최적화하는 것 사이의 전형적인 트레이드오프를 훨씬 더 어렵게 하기 때문에 검사 단계 수가 더 엄격하게 제한됩니다. 동시에 첨단 트랜지스터의 피처 크기는 매우 작기 때문에 수율을 저하시키는 결함을 노이즈와 구별하기 매우 어렵게 만들며, 작은 변동이 3D 구조를 제조하고 복잡한 다중 패터닝 단계를 수행할 때 수율을 저하시키는 결함으로 발전할 수 있습니다.
Enlight™ 3 Brightfield 광학 검사 시스템은 칩 제조업체가 요구되는 검사 감도, 검사 빈도를 달성하면서 더 많은 데이터를 수집하고 수율을 높임과 동시에 웨이퍼당 비용을 절감할 수 있도록 공정 제어를 재정립하기 위해 어플라이드가 집중하고 있는 노력 중 일부입니다. 이 시스템은 업계 최고의 광학 기술을 고해상도 및 첨단 AI 알고리즘과 결합하여 스캔당 더 많은 데이터를 캡처합니다. Enlight 3의 고유한 아키텍처는 시장에서 가장 높은 분해능력을 제공하여 고해상도 스캔을 가능하게 할 뿐만 아니라, 웨이퍼 노이즈를 억제하는 고유한 3D 편광 제어를 실현합니다. 또한 Brightfield 및 greyfield 감지 채널을 동시에 지원하여 제조에 있어 고품질 빅데이터의 새로운 세대를 가능하게 합니다.
새로운 신호 향상, AI 알고리즘 및 처리 능력은 Enlight 3를 우리의 가장 강력한 광학 검사 옵션으로 만듭니다. 또한 Enlight 3는 고도의 brightfield부터 시간당 30 웨이퍼를 처리할 수 있는 darkfield 애플리케이션까지 매우 넓은 애플리케이션 분야를 지원합니다.
칩 제조업체는 검사 도구의 감도를 낮춰 불필요한 결함 검출을 최소화할 수 있지만, 이렇게 하면 중요한 결함을 놓칠 위험이 높아집니다. 이러한 문제를 완화하기 위해 Applied ExtractAI* 는 Enlight 3의 빅데이터를 사용하여 고객이 in-line 모니터링 중에 완전히 분류된 노이즈 없는 검사지도를 신속하게 생성할 수 있도록 합니다.
Enlight 3 어플라이드의 3세대 ExtractAI 기술과 결합되어 brightfield 광학 웨이퍼 검사와 업계 최고의 전자빔 리뷰 시스템인 SEMVision™ 간의 실시간 지능형 연결을 제공합니다. 이 강력한 3가지 조합은 적응형 AI 기반 패턴 인식을 생성하여 공정 엔지니어가 수율을 저하시키는 결함에 대한 실행 가능한 통찰력을 생성하거나 칩 제조업체가 보유비용(CoO)을 낮추고, 수율을 증가시키며, 개발을 가속화하고, 수익 창출 시간을 단축하며, 노드 수명 동안의 이익증가를 가능하게 합니다.

어플라이드 머티어리얼즈의 Enlight 광학 검사, ExtractAI™ 기술 및 SEMVision 전자빔 리뷰는 가장 빠른 속도로 가장 실행 가능한 데이터를 제공하여 새로운 프로세스 노드의 시장 출시 시간을 단축합니다.


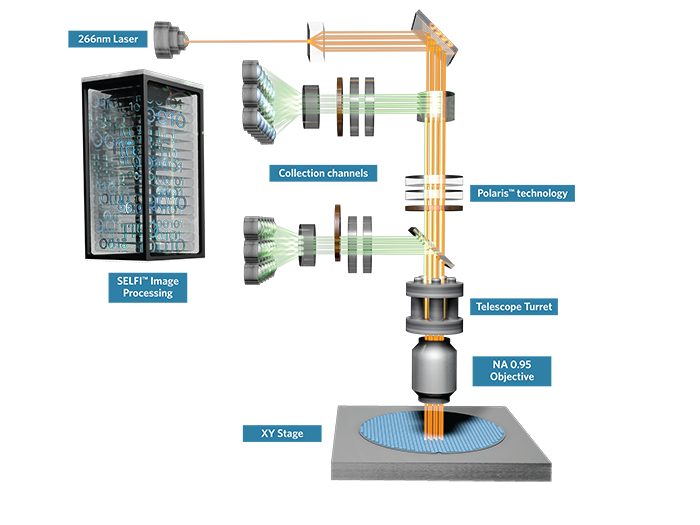
- 1 / 3
- 2 / 3
- 3 / 3
*ExtractAI 기술은 고급 광학 스캐너에서 생성되는 수백만 개의 방해 신호 또는 '노이즈' 중 수율을 떨어뜨리는 결함을 빠르고 정확하게 구분합니다. ExtractAI 기술은 샘플의 1000분의 1 정도만 검토해 웨이퍼 맵의 모든 잠재적 결함을 확인할 수 있는 매우 효율적인 기술입니다. 그 결과 노드 개발, 램프 및 수율을 가속화하는 결함별 실행 가능한 맵이 생성됩니다.
